 |
|
МЕНЮФестивали и конкурсы Семинары Издания О МОДНТ Приглашения Поздравляем НАУЧНЫЕ РАБОТЫ |
Реферат: Физические основы электроники3.4 Линейная (малосигнальная) модель биполярного транзистора В качестве малосигнальных моделей могут быть использованы эквивалентные схемы с дифференциальными h-, у- и z-параметрами, которые имеют формальный характер и в которых отсутствуют непосредственная связь с физической структурой транзистора. Например, эквивалентная схема для системы Н-параметров приведена на рисунке 3.9.
Рисунок 3.9 Эквивалентна схема БТ в системе Н-параметров. Широкое распространение нашли эквивалентные схемы с так называемыми физическими параметрами, которые опираются на нелинейную динамическую модель Эберса - Молла, т.е. тесно связаны с физической структурой биполярного транзистора. Малосигнальную схему БТ легко получить из нелинейной динамической модели заменой эмиттерного и коллекторного диодов их дифференциальными сопротивлениями, устанавливающими связь между малыми приращениями напряжения и тока. Кроме того, в усилительных схемах используется либо нормальный активный, либо инверсный активный режим, а режим насыщения недопустим. Поэтому при переходе к малосигнальной схеме можно ограничиться рассмотрением наиболее распространенного нормального активного режима, так как результаты легко перенести и на инверсный активный режим. В этом случае можно исключить генератор тока и малосигнальную модель БТ для схемы включения с ОБ можно изобразить, как на рисунке 3.10.
Рисунок 3.10 Эквивалентная схема БТ при включении его с ОБ. Поясним смысл элементов модели. Резистор RЭ представляет дифференциальное сопротивление эмиттерного перехода. В первом приближении его можно определить по формуле для идеализированного р-n перехода: RЭ=dU/dI»jT/IЭ, (3.28) где IЭ- постоянная составляющая тока эмиттера. Так как при комнатной температуре jт = 0,026 В, то при IЭ = 1 мА RЭ = 26 Ом. Величина RК называется дифференциальным сопротивлением коллекторного перехода. Оно обусловлено эффектом Эрли и может быть определено по наклону выходной характеристики: Величина RК обратно пропорциональна значению параметра h22Б. Дифференциальное сопротивление коллектора может составлять сотни килоом и мегаомы, тем не менее его следует учитывать. Реактивные элементы модели (Сэ, Ск) оказались теперь присоединенными параллельно резисторам RЭ и RК. Сопротивление базы r½ББ, которое может превышать сотни ом, всегда остается в модели. r½ББ=h12/h22 . (3.30) Приведенная эквивалентная малосигнальная модель БТ формально относится к схеме включения с ОБ. Однако она применима и для схемы с ОЭ. Для этого достаточно поменять местами плечи этой схемы, называемой Т-образной схемой с физическими параметрами. Электрод “Б” следует изобразить входным, а “Э” - общим, как показано на рисунке 3.11.
Рисунок 3.11 Эквивалентная схема БТ при включении его с ОЭ. Значения всех элементов остаются прежними. Однако при таком изображении появляется некоторое неудобство, связанное с тем, что зависимый генератор тока в коллекторной цепи выражается не через входной ток (ток базы). Этот недостаток легко устранить преобразованием схемы к виду, изображенному на рисунке 3.11. Чтобы обе схемы были равноценными четырехполюсниками, они должны иметь одинаковые параметры в режимах холостого хода и короткого замыкания. Это требует перехода от тока H21БIЭ к току Н21ЭIБ и замены RК и CК на RК* и CК* соответственно. Связи этих величин определяются формулами RК*=Н21БRК/ Н21Э=RК /( Н21Э+1) , ( 3.31 ) СК*= СК( Н21Э+1) . ( 3.32 ) Легко убедиться, что RК* характеризует наклон выходной характеристики (эффект Эрли) в схеме с ОЭ и связан с выходной проводимостью в этой схеме соотношением (5.43). Во сколько раз уменьшается RК* по сравнению с RК, во столько же раз возрастает емкость СK* по сравнению с СK, т.е. RKCK =RK*CK*. ] 3.5 Частотные свойства биполярного транзистора Частотные свойства определяют диапазон частот синусоидального сигнала, в пределах которого прибор может выполнять характерную для него функцию преобразования сигнала. Принято частотные свойства приборов характеризовать зависимостью величин его параметров от частоты. Для биполярных транзисторов используется зависимость от частоты коэффициента передачи входного тока в схемах ОБ и ОЭ Н21Б и Н21Э. Обычно рассматривается нормальный активный режим при малых амплитудах сигнала в схемах включения с ОБ и ОЭ. В динамическом режиме вместо приращения токов необходимо брать комплексные амплитуды, поэтому и коэффициенты передачи заменяются комплексными (частотно зависимыми) величинами: Н21Б и Н21Э. Величины Н21Б и Н21Э могут быть найдены двумя способами: -решением дифференциальных уравнений физических процессов и определением из них токов; -анализом Т-образной эквивалентной схемы по законам теории электрических цепей. Во втором случае Н21Б и Н21Э будут выражены через величины электрических элементов схемы. Мы проведем анализ частотных свойств коэффициентов передачи, используя Т-образную линейную модель (эквивалентную схему) n-р-n транзистора (рисунки 3.10 и 3.11). На частотные свойства БТ влияют СЭ, СК и r½ББ, а также время пролета носителей через базу tБ. Нет надобности рассматривать влияние на частотные свойства транзистора каждого элемента в отдельности. Совместно все эти факторы влияют на коэффициент передачи тока эмиттера Н21Б, который становится комплексным, следующим образом:
где Н21Б0- коэффициент передачи тока эмиттера на низкой частоте, f - текущая частота, fН21Б- предельная частота. Модуль коэффициента передачи тока эмиттера равен:
Не трудно заметить, что модуль коэффициента передачи ½Н21Б½на предельной частоте fН21Б снижается в Сдвиг по фазе между входным и выходным токами определяется формулой
Для схемы с ОЭ известно соотношение
Подставляя (3.33) в (3.36) получим
где Модуль коэффициента передачи тока базы будет равен
Как видно, частотные свойства БТ в схеме ОЭ значительно уступают транзистору, включенному по схеме с ОБ. Граничная частота fГР - это такая частота, на которой модуль коэффициента передачи ½Н21Э½=1. Из (3.38) получим, что fГР»fН21Э×Н21Э0. Транзистор можно использовать в качестве генератора или усилителя только в том случае, если его коэффициент усиления по мощности КP>1. Поэтому обобщающим частотным параметром является максимальная частота генерирования или максимальная частота усиления по мощности, на которой коэффициент усиления по мощности равен единице. Связь этой частоты с высокочастотными параметрами определяется выражением
где fН21Б-предельная частота в мегагерцах; r1ББ-объемное сопротивление в омах; CК-емкость коллекторного перехода в пикофарадах; fМАКС-в мегагерцах. 3.6 Способы улучшения частотных свойств биполярных транзисторов Рассмотренное выше позволяет сделать следующие выводы. Для улучшения частотных свойств (повышение предельной частоты ) рекомендуется следующее. 1. Уменьшать время пролета инжектированных носителей в базовой области, т.е. а) уменьшать ширину базовой области WБ; б) создавать n-р-n транзисторы, так как подвижность электронов выше, чем у дырок, примерно в 2 раза; в) использовать германиевые БТ, так как в германии подвижность носителей выше. Еще большие возможности открывает использование арсенида галлия. 2. Создавать ускоряющее поле в базовой области для инжектированных из эмиттера носителей. Последнее возникает при неравномерном распределении примесей в базе по направлению от эмиттера к коллектору (рисунок 3.12). Концентрацию около эмиттера делают примерно в 100 раз больше, чем около коллектора.
Рисунок 3.12 К образованию электрического поля в базе дрейфого БТ. Появление поля объясняется просто. Так как концентрация основных носителей в любой точке базы (дырок n-р-n транзистора) приблизительно равна концентрации примесей в этой точке, то распределение примесей Na(х) одновременно будет и распределением дырок p(х). Под влиянием градиента концентрации дырок будет происходить их диффузионное движение к коллектору, приводящее к нарушению условия электрической нейтральности: около эмиттера будет избыток отрицательного заряда ионов акцепторов, а около коллектора - избыток положительного заряда дырок, которые приходят к коллекторному переходу, но не проходят через него. Нарушение электрической нейтральности приводит к появлению внутреннего электрического поля в базовой области (минус у эмиттера, плюс у коллектора). Появляющееся поле, в свою очередь, вызовет встречное дрейфовое движение дырок. Нарастание поля и дрейфового потока будет происходить до того момента, когда дрейфовый и диффузионный токи дырок уравняются. Легко видеть, что установившееся (равновесное) значение поля будет ускоряющим для электронов, которые входят в рабочем режиме из эмиттера в базу и будут уменьшать их время пролета, т.е. повышать предельную частоту БТ. Биполярные транзисторы с неравномерным распределением примесей в базе, приводящим к появлению ускоряющего поля, называются дрейфовыми, а обычные - бездрейфовыми. Практически все современные высокочастотные и сверхвысокочастотные БТ являются дрейфовыми. Уменьшение времени пролета в базовой области n-р-n транзистора при экспоненциальном законе убывания концентрации акцепторов от Nа(0) до Nа(WБ) учитывается коэффициентом неоднородности базы: h=0,5ln[NА(0)/NА(WБ)] Поэтому [см. (5.93)] можно написать
Для бездрейфовых
транзисторовh=0 , а типичные
значения для дрейфовых транзисторов 3. Уменьшать барьерные емкости эмиттерного и коллекторного переходов путем уменьшения сечения областей транзистора и увеличения ширины переходов (выбором концентрации примесей и рабочего напряжения). 4. Уменьшать омическое сопротивление областей базы r½ББ. 5. Уменьшать время пролета носителей в области коллекторного перехода. Следует отметить, что ряд требований несовместимы и необходимо при создании транзисторов применять компромиссные решения. 3.7 Работа транзистора в усилительном режиме При работе транзистора в различных радиотехнических устройствах в его входную цепь поступают сигналы, например переменные напряжения. Под действием входного переменного напряжения изменяются входной и выходной токи транзистора. Для выделения полезного сигнала в выходную цепь транзистора включают элементы нагрузки. В простейшем случае нагрузкой может служить резистор Rк. На резисторе нагрузки за счет прохождения выходного тока выделяется, кроме постоянного, переменное напряжение. Амплитуда этого напряжения зависит от амплитуды переменной составляющей выходного тока и сопротивления резистора Rк и может быть больше входного напряжения. Процесс усиления сигнала удобно рассмотреть на примере простейших усилителей. Простейшая схема усилителя на транзисторе, включенном по схеме с ОЭ, показана на рисунке 3.13. Коллекторная цепь состоит из резистора Rк и источника Ек, а цепь базы - из источников тока IБ0 и IБm Источник IБ0 обеспечивает положение исходной рабочей точке на участке характеристик с наименьшей нелинейностью. Источник IБm- источник сигнала. В качестве выходного используется переменное напряжение, выделяемое на резисторе нагрузки Rк (на коллекторе транзистора).
Рисунок 3.13 Схема усилителя на БТ. Работа такого усилителя поясняется временными диаграммами токов и напряжений, изображенными на рис. 3.. При IБm =0 токи базы и коллектора будут определяться токами в рабочей точке (IБ 0, IК 0)и напряжением на коллекторе UК0= ЕК-IК 0 × Rк
Рисунок 3.14 Временные диаграммы усилителя. Во время положительного полупериода входного тока (рис. 3.14, а) прямое напряжение эмиттерного перехода увеличивается, что вызывает рост тока коллектора (рис. 3.14, б) и уменьшение напряжения UКЭ за счет увеличения падения напряжения на сопротивлении коллектора (рисунок 3.14, в). Если работа происходит на линейных участках характеристик транзистора, то формы переменных составляющих токов базы и коллектора совпадают с формой входного напряжения, а переменное напряжение на коллекторе, обусловленной переменной составляющей коллекторного тока, оказывается сдвинутым относительно входного напряжения на 1800. При соответствующем выборе сопротивления нагрузки Rк амплитуда переменного напряжения на выходе такого усилителя Umвых=IКmRк может значительно превышать амплитуду входного напряжения. В этом случае происходит усиление сигнала. Расчет параметров усиления дан в [4]. 3.8 ОСОБЕННОСТИ РАБОТЫ ТРАНЗИСТОРА В ИМПУЛЬСНОМ РЕЖИМЕ 3.8.1 Работа транзистора в режиме усиления импульсов малой амплитуды Если транзистор работает в режиме усиления импульсных сигналов малой амплитуды, то такой режим работы в принципе не отличается от линейного усиления малых синусоидальных сигналов. Импульс в этом случае может быть представлен в виде суммы ряда гармонических составляющих. Зная частотные свойства транзистора, можно определить искажения формы импульсов, возникающие при усилении. Схема импульсного усилителя не отличается от схемы усилителя гармонических сигналов (рисунок 3.13). 3.8.2 Работа транзистора в режиме переключения Биполярный транзистор широко используется в электронных устройствах в качестве ключа - функцией которого является замыкание и размыкание электрической цепи. Имея малое сопротивление во включенном состоянии и большое - в выключенном, биполярный транзистор достаточно полно удовлетворяет требованиям, предъявляемым к ключевым элементам. Схема транзисторного ключа показана на рисунке 3.15. Во входной цепи действуют источник смещения ЕБЭ, создающий обратное напряжение на эмиттерном переходе, источник управляющих импульсов прямого напряжения UВХ и ограничительный резистор RБ. Обычно RБ>>Н11Э. В выходной цепи включены сопротивление нагрузки RК и источник питания ЕКЭ.
Рисунок 3.15 Схема импульсного усилителя. Когда нет импульса на входе, транзистор находится в режиме отсечки и ток коллектора практически отсутствует IК»IКБ0 (точка А на выходных характеристиках (рисунок 3.16,б). Напряжение на выходе транзистора uКЭ= ЕКЭ-IК× RК » ЕКЭ. При подаче на вход транзистора импульсов прямого тока iБ=(UВХ- EБЭ)/RБ=IБ НАС, транзистор открывается, рабочая точка перемещается в точку Б (режим насыщения) и напряжение на коллекторе падает до значения uКЭ= ЕКЭ-IК НАС× RК=UКЭ ОСТ. При дальнейшем увеличении тока базы ток коллектора не увеличивается (рисунок 3.16,а).и напряжение на коллекторе не изменяется (рисунок 3.16,б).
3.8.3 Переходные процессы при переключении транзистора При практическом использовании транзистора большое значение имеет скорость переключения, обуславливающая быстродействие аппаратуры. Скорость переключения определяется процессами накопления и рассасывания неравновесного заряда в базе и коллекторе транзистора, эмиттерном и коллекторном переходах. В эмиттерном и коллекторном переходах находятся нескомпенсированные заряды неподвижных ионизированных атомов примеси- доноров и акцепторов; неравновесный заряд отсечки в базе можно считать равным нулю. При переходе к режиму насыщения эмиттерный переход открывается, толщина перехода и его нескомпенсированный заряд уменьшаются, происходит как бы разряд ёмкости эмиттерного перехода. Вследсвии понижения напряжения на коллекторе, уменьшается его толщина и заряд в нем, т.е. происходит разряд ёмкости коллекторного перехода, открывается коллекторный переход и в области базы за счет инжекции электронов из эмиттерного и коллекторного переходах накапливается большой неравновесный заряд насыщения. В транзисторах, имеющих высокоомный коллектор носители заряда инжектируют и в область коллектора, где так же накапливается неравновесный заряд. Графики напряжений и токов транзистора при переключении даны на рисунке 3.17. На базу транзистора подается прямоугольный импульс напряжения UВХ-EБЭ (рисунок 3.17,а). График входного тока показан на рисунке 3.17,б. Величина импульса прямого тока базы IБ ПР определяется в основном сопротивлением ограничительного резистора RБ. После переключения эмиттерного перехода на обратное направление ток перехода, как и в диоде, имеет первоначально большую величину, ограниченную лишь сопротивлением RБ: IБ ОБР= EБ/ RБ, так как сопротивление эмиттерного перехода в первый момент после переключения очень мало вследствие насыщения базы неравновесными носителями заряда (рисунок 3.17,г). При прямоугольной форме импульса входного тока импульс выходного тока iК (рисунок 3.17,в) появляется с задержкой tЗ, которая определяется главным образом скоростью нарастания напряжения эмиттерного перехода, зависящей от величин ёмкости перехода и прямого тока базы, т.е. скоростью разряда эмиттерного перехода. После того как
транзистор перейдет из режима отсечки в активный режим, коллекторный ток
начинает постепенно нарастать, достигая установившегося значения а время tн. Это время определяется скоростью накопления
неравновесного заряда в базе и скоростью разряда емкости коллектора. Таким
образом, полное время включения транзистора состоит Рисунок 3.17 Переходные процессы при переключении БТ. из времени задержки и времени нарастания: Практически оно может иметь величину от нескольких наносекунд до нескольких микросекунд в зависимости от параметров транзистора. После подачи в цепь базы запирающего тока IБ ОБР=EБЭ/RБ выходной коллекторный ток прекращается не сразу. На протяжении некоторого времени рассасывания tp он практически сохраняет свою величину, так как концентрация носителей заряда в базе у коллекторного перехода еще остается выше равновесной и коллекторный переход благодаря этому оказывается открытым. Лишь после того как неравновесный заряд у коллекторного перехода рассосется за счет ухода электронов из базы и рекомбинации, ток коллектора начинает постепенно спадать, достигая время спада tС установившегося значения IKЭ0. В течении этого времени продолжается рассасывание неравновесного заряда базы и происходит перезаряд емкости коллекторного перехода. Заметим, что эмиттерный переход при этом может закрыться раньше или позже коллекторного в зависимости от скорости рассасывания неравновесного заряда, сосредоточенного поблизости от него. Процесс накопления и рассасывания неравновесного заряда qБ при переключении транзистора поясняется на рисунке 3.17,г. Накопление неравновесного заряда в базе начинается спустя время задержки tз, и заряд за время нарастания tн достигает установившегося значения qБ=Qакт. Далее вследствие падения коллекторного напряжения до величины UКЭ ОСТ< UБЭ коллекторный переход открывается и начинает инжектировать неравновесные носители заряда в базу. Заряд базы снова возрастает, достигая к концу входного импульса значения qБ=Qнас. После переключения напряжения эмиттерного перехода на обратное происходит рассасывание неравновесного заряда базы, за время tР+tС он достигает нулевого значения. 4 ПОЛЕВЫЕ ТРАНЗИСТОРЫ4.1 Полевой транзистор с p-n переходом. В полевых транзисторах, управление потоком основных носителей заряда осуществляется в области полупроводника, называемой каналом, путем изменения его поперечного сечения с помощью электрического поля. Полевой транзистор имеет следующие три электрода: исток, через который в n канал втекают основные носители; сток, через который они вытекают из канала, и затвор, предназначенный для регулирования поперечного сечения канала. В настоящее время существует множество типов полевых транзисторов, которые в ряде устройств работают более эффективно, чем биполярные. Преимуществом полевых транзисторов является также и то, что ассортимент полупроводниковых материалов для их изготовления значительно шире (так как они работают только с основными носителями заряда), благодаря чему возможно создание, например, темпера -туростойких приборов. Большое значение также имеют низкий уровень шумов и высокое входное сопротивление этих транзисторов. На рисунке 4.1 приведена схема включения полевого транзистора.
Полевой транзистор работает следующим образом. При отсут-
ствии напряжения на входе основные носители заряда - электроны под действием ускоряющего электрического ноля в канале (E = 105Q104 В/см) дрейфуют в направлении от истока к стоку, в то время как p-n переход для них заперт. Ток IС, создаваемый этими электронами, определяется как напряжением стока UСИ, так и сопротивлением канала. Последнее зависит от поперечного сечения канала, которое ограничивается p-n переходом (заштрихованная область). Поскольку потенциал электрического поля линейно возрастает от истока к стоку вдоль канала, толщина p-n перехода минимальна вблизи истока и максимальна вблизи стока, и канал сужается вдоль p-n перехода от стока к истоку. Таким образом, наибольшим сопротивлением канал обладает в наиболее узкой своей части. Если в результате подачи к затвору переменного напряжения сигнала результирующее обратное напряжение на затворе UЗИ повысятся, то толщина p-n перехода по всей его длине увеличится, а площадь сечения канала и, следовательно, ток в цепи стока уменьшаются. На рисунке 4.2,а изображена характеристика
прямой передачи IС =f(UЗИ). Указанный эффект будет тем сильнее, чем больше удельное сопротивление материала полупроводника, поэтому полевые транзисторы выполняют из высокоомного материала. При больших обратных напряжениях на затворе UЗИ0 сечение канала в его узкой части станет равным нулю и ток через канал прекратится. Такой режим называется режимом отсечки. Характеристика прямой передачи хорошо описывается формулой Па рисунке 4.2,б изображено семейство статических выходных характеристик IС =f(UСИ) при различных значениях напряжения затвора UЗИ. Каждая характеристика имеет два участка - омический (для малых UСИ) и насыщения (для больших UСИ). При UЗИ = 0 с увеличением напряжения UС ток IС вначале нарастает почти линейно, однако далее характеристика перестает подчиняться закону Ома; ток IС начинает расти медленно, ибо его увеличение приводит к повышению падения напряжения в канале и потенциала вдоль канала. Вследствие этого увеличиваются толщина запирающего слоя и сопротивление канала, а также замедляется возрастание самого тока IС. При напряжении насыщения UСИ = UЗИ0 сечение канала приближается к нулю и рост IС прекращается. Следующая характеристика, снятая при некотором обратном напряжении затвора U^ЗИ, когда запирающий слой имеет большую толщину при тех же значениях UСИ, будет более пологой на начальном участке и насыщение наступит раньше (при меньших значениях U^СИ=UЗИ0 -U^ЗИ). Температурная зависимость тока истока связана с изменением подвижности основных носителей, заряда в материале канала. Для кремниевых транзисторов крутизна S уменьшается с увеличением температуры. Кроме того, с повышением температуры увеличивается собственная проводимость полупроводника, возрастает входной ток IЗ черед переход и, следовательно, уменьшается RВХ. У полевых кремниевых транзисторов с p-n переходом при комнатной температуре ток затвора порядка 1 нА. При увеличении температуры ток удваивается на каждые 10°С. Особенность полевых транзисторов заключается в наличии у них термостабильной точки, т. е. точки, в которой ток стока практически постоянен при различных температурах (рисунок 4.3). Это объясняется следующим образом. При повышении температуры из-за уменьшения подвижности носителе удельная проводимость канала уменьшается, а следовательно, уменьшается и ток стока. Одновременно сокращается ширина p-n перехода, расширяется проводящая часть канала и увеличивается ток. Первое сказывается при больших токах стока, второе при малых. Эти два противоположных процесса при определенном выборе рабочей точки могут взаимно компенсироваться. При правильном выборе ее положения основной
причиной дрейфа тока стока может быть высокоомный резистор в цепи в зависимости от температуры будет изменяться падение напряжения по входной цепи,которое изменит рабочий ток стока. Основным параметрам, используемым при расчете усилительного каскада с полевым транзистором, является статическая крутизна характеристики прямой передачи, т. е. отношение изменения тока стока к напряжению между затвором и истоком:
Дифференциальное выходное сопротивление здесь определяется как
Оно составляет, примерно десятки — сотни килоомов. Статический коэффициент усиления по напряжению m=DUСИ/DUЗИ =S'Ri . Определение параметров по характеристикам дано в [4]. Междуэлектродные емкости затвор-исток СЗИ затвор-сток СЗС и сток-исток ССИ. Для маломощных транзисторов СЗИ=3 пФ, СЗС=2 пФ и ССИ=0,2 пФ. Ток затвора во входной цепи триода IЗ —обратный ток, создаваемый неосновными носителями через p-n переход, чрезвычайна мал (порядка 10-9 А и менее). Поэтому входное сопротивление полевого транзистора RВХ=DUЗ/DIЗ очень высокое (порядка нескольких мегомов), входная же емкость мала, так как переход находится под обратным напряжением. Этими качествами полевой транзистор выгодно отличается от биполярных транзисторов с двумя p-n переходами. При работе полевого транзистора на высоких частотах основное значение имеет емкость СЗИ. Максимальная рабочая частота определяется постоянной времени входной цепи f=1/2pRCЗИ, где R - сопротивление канала, через которое заряжается емкость. Анализ показывает, что по частотным свойствам полевой транзистор не имеет особых преимуществ перед биполярным. Практически были осуществлены полевые транзисторы с максимальной частотой генерации до 30 ГГц. Но с точки зрения быстродействия полевой транзистор превосходит биполярный, так как работает на основных носителях заряда при отсутствии их накопления. В импульсном режиме чрезвычайно полезным достоинством полевого транзистора является почти полное отсутствие остаточного напряжения и цепи канала во включенном состоянии. Закрытый полевой транзистор оказывает сопротивление постоянному току между стоком и истоком более 108 Ом. Полевые транзисторы с p-n переходом целесообразно применять во входных устройствах усилителей при работе от высокоомного источника сигнала, в чувствительной по току измерительной аппаратуре, импульсных схемах, регуляторах уровня сигнала и т. п. 4.2 Полевой транзистор с изолированным затвором (МДП-транзистор). Этот транзистор имеет структуру металл - диэлектрик - полупроводник и может быть двух типов: с индуцированным каналом (рисунок 4.4,а) и с встроенным каналом (рисунок 4.4,б). Если основой транзистора является кремний, то диэлектриком может быть слой окиси кремния, поэтому такую структуру иногда называют МОП-транзистор (металл - окисел - полупроводник).
Транзистор с индуцированным каналом имеет области истока n+ и стока n+, которые выведены путем металлизации через отверстие в окиси кремния на контакты - исток и сток. На слой двуокиси окиси кремния напыляют слой алюминия, служащий затвором. Можно считать, что алюминиевый затвор и полупроводниковый материал p-типа образуют плоский конденсатор с окисным диэлектриком, Если на металлическую часть затвора подать положительное напряжение, то положительный заряд обкладки затвора индуцирует соответствующий отрицательный заряд в полупроводниковой области канала. С возрастанием положительного напряжения этот заряд, созданный притянутыми из глубины p-области проводника электронами, которые являются неосновными носителями, превращает поверхностны слой полупроводника p-типа в проводящий канал n-типа, соединяющий исходные n+-области истока и стока. Поэтому уменьшается сопротивление материала между истоком и стоком, что ведет к увеличению тока стока. Таким образом, благодаря электростатической индукции между истоком и стоком происходит инверсия типа проводимости полупроводника. Слой полупроводника p-типа превращается в полупроводник n-типа. До инверсии сопротивление между истоком и стоком определяется сопротивлением закрытого перехода, так как до инверсии имеет место структура n+-р-n+. После инверсии образуется n-проводимость и структура становится n+-n-n+. Меняя напряжение на затворе, можно управлять током стока. Если взять подложку n-типа, то можно построить МДП-транзистор с индуцированным p-каналом, который управляется отрицательным напряжением на затворе. Транзистор с встроенным каналом имеет конструкцию, подобную предыдущей. Между истоком и стоком методом диффузии создают слаболегированный канал c проводимостью n--типа при проводимости подложки p-типа. Возможно другое сочетание. Канал имеет проводимость p-типа, а подложка — проводимость n-типа. В отсутствие напряжения на затворе (рис. 2.91б) ток между истоком и стоком определяется сопротивлением n--канала. При отрицательном напряжении на затворе концентрация носителей заряда и канале уменьшится и в нем появляется обедненный слой. Сопротивление между истоком и стоком увеличивается и ток уменьшается. При положительном напряжении на затворе ток стока увеличивается, потому что в канале индуцируется дополнительный отрицательный заряд, увеличивающий его проводимость. На рисунке 4.4 приведены характеристики прямой передачи МДП-транзисторов с индуцированным (кривая 2) и встроенным (кривая 1) каналами.
видна квадратичность передаточной характеристики. Теоретически характеристика прямой передачи описывается следующим выражением:
Здесь А - постоянный коэффициент; UЗИ ПОР - напряжение, которое для транзистора с индуцированным каналом принято называть пороговым. Инверсия типа проводимости начинается лишь при достижении напряжения UПОР.
Выходные характеристики МДП-транзистора с индуциро- ванным каналом n-типа приведены на рисунке 4.5,а со встроенным каналом - на рисунке 4.5,б. В области UCИ < |UЗИ - UЗИ ПОР | теоретический ток стока
Уравнение (3.42) описывает восходящие ветви выходной характеристики Входное сопротивление МДП-транзистора из-за наличия изолятора между затвором и каналом составляет около 1012 - 1014 Ом и уменьшается с ростом частоты вследствие шунтирования входной емкостью транзистора. Выходное сопротивление находится в пределах десятков - сотен килоомов. Входная и выходная емкости составляют единицы пикофарад, а проходная емкость -десятые доли пикофарад.
Литература 1 Электронные , квантовые приборы и микроэлектроника. Под редакцией Федорова Н.Д. - М.: Радио и связь, 1998.-560 с. 2 Электронные приборы. Под редакцией Шишкина Г.Г. -М.: Энергоатомиздат, 1989.-496 с. 3 Батушев В.А. Электронные приборы. -М.: Высшая школа, 1980. -383 с. 4 Савиных В. Л. Физические основы электроники. Методические указания и контрольные задания. СибГУТИ, 2002. ктн, доц. Валерий Леонидович Савиных, Физические основы электроники Учебное пособие
Редактор доц. Удальцов А.Н. Корректор Шкитина Д.С.
Лицензия №020475, январь 1998 г. Подписано в печать Формат бумаги 62 х 84 1/16 Бумага писчая №1. Уч. изд. л. Тираж экз. Заказ № СибГУТИ, 630102, г. Новосибирск, ул. Кирова, 86. |
|||||||||||||||||||||
Приглашения
09.12.2013 - 16.12.2013
Международный конкурс хореографического искусства в рамках Международного фестиваля искусств «РОЖДЕСТВЕНСКАЯ АНДОРРА»
09.12.2013 - 16.12.2013
Международный конкурс хорового искусства в АНДОРРЕ «РОЖДЕСТВЕНСКАЯ АНДОРРА»




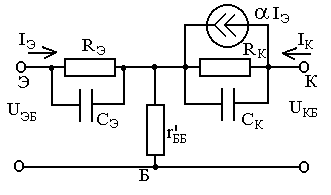
 . (3.29)
. (3.29)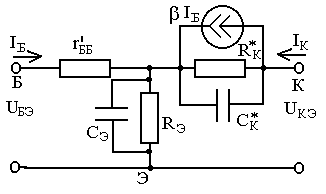
 , (3.33 )
, (3.33 ) ( 3.34 ).
( 3.34 ). . ( 3.35 )
. ( 3.35 )
 (3.37),
(3.37), .
. (3.38).
(3.38). , ( 3.39 ).
, ( 3.39 ).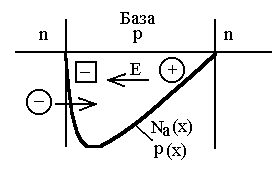

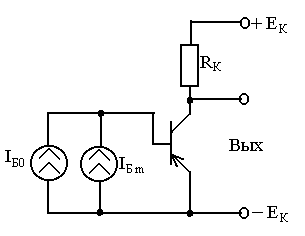
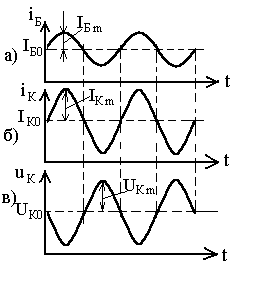
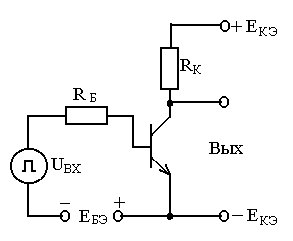
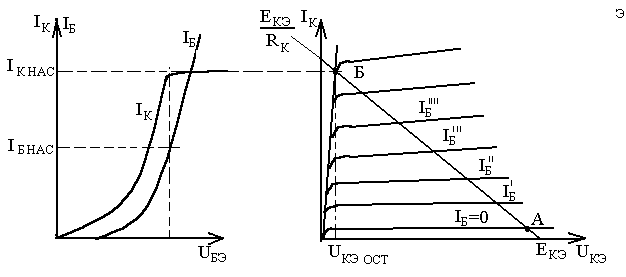
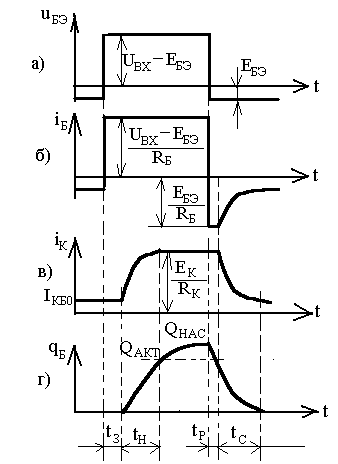
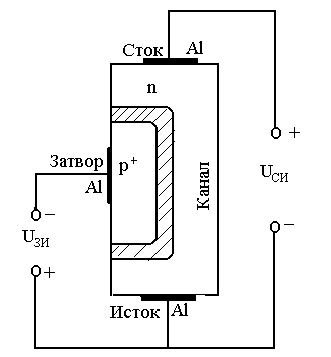 Во входную
цепь включен источник обратного смещения UЗИ на p-n переходе между
затвором и каналом. Выходная цепь состоит из источника постоянного напряжения UСИ
плюсом соединенного к стоку. Исток является общей точкой схемы. Контакты истока
и стока невыпрямляющие. Канал может иметь электропроводимость, как p-типа, так
и n-типа; поскольку mn>mp выгоднее применять n-канал.
Затвор выполняют в виде полупроводниковой области p+-типа.
Во входную
цепь включен источник обратного смещения UЗИ на p-n переходе между
затвором и каналом. Выходная цепь состоит из источника постоянного напряжения UСИ
плюсом соединенного к стоку. Исток является общей точкой схемы. Контакты истока
и стока невыпрямляющие. Канал может иметь электропроводимость, как p-типа, так
и n-типа; поскольку mn>mp выгоднее применять n-канал.
Затвор выполняют в виде полупроводниковой области p+-типа.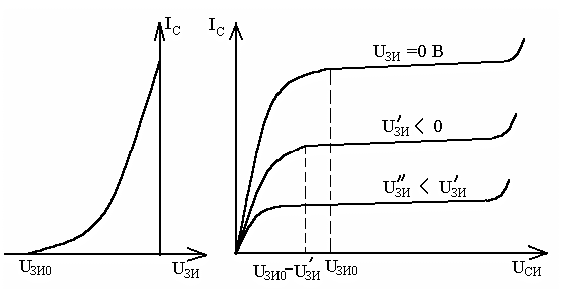
 (3.40)
(3.40)

 , Ом,
, Ом,