 |
|
МЕНЮФестивали и конкурсы Семинары Издания О МОДНТ Приглашения Поздравляем НАУЧНЫЕ РАБОТЫ |
Реферат: Физические основы электроникиЕсли сопротивление запирающего слоя обозначить rд, то кристалл полупроводника с запирающим слоем можно представить в виде последовательного соединения резисторов rд и r1. При прохождении тока IПР на сопротивлении r1 падает часть напряжения внешнего источника и на запирающем слое действует напряжение UПЕР = UПР – IПР×r1. Уравнение вольтамперной характеристики в этом случае может быть записано в следующем неявном виде:
Рисунок 1.12 Упрощенная эквивалентная схема p-n перехода с распределенным сопротивлением полупроводника. Поскольку UПЕР < UПР реальная характеристика идет ниже теоретической. Когда напряжение на запирающем слое становится равным контактной разности потенциалов, запирающий слой исчезает, и дальнейшее увеличение тока ограничивается распределенным сопротивлением полупроводников p- и n-типа. Таким образом, в точке С при UПР = UК вольтамперная характеристика переходит в прямую линию. 1.3.6 Емкости p-n перехода Изменение внешнего напряжения dU на p-n переходе приводит к изменению накопленного в нем заряда dQ. Поэтому p-n переход ведет себя подобно конденсатору, емкость которого С = dQ/ dU. В зависимости от физической природы изменяющегося заряда различают емкости барьерную (зарядную) и диффузионную. Барьерная (зарядная) емкость определяется изменением нескомпенсированного заряда ионов при изменении ширины запирающего слоя под воздействием внешнего обратного напряжения. Поэтому идеальный электронно-дырочный переход можно рассматривать как плоский конденсатор, емкость которого определяется соотношением
где П, d - соответственно площадь и толщина p-n перехода. Из соотношений (1.41) и (1.31) следует
В общем случае зависимость зарядной емкости от приложенного к p-n переходу обратного напряжения выражается формулой
где C0 — емкость p-n перехода при UОБР = 0; g - коэффициент, зависящий от типа p-n перехода (для резких p-n переходов g = 1/2, а для плавных g = 1/3). Барьерная емкость увеличивается с ростом NА и NД, а также с уменьшением обратного напряжения. Характер зависимости СБАР = f(UОБР) показан на рис. 1.13,а. Рассмотрим
диффузионную емкость. При увеличении внешнего напряжения, приложенного к p-n
переходу в прямом направлении, растет концентрация инжектированных носителей
вблизи границ перехода, что приводит к изменению количества заряда,
обусловленного неосновными носителями в p- и n-областях. Это можно рассматривать
как проявление некоторой емкости. Поскольку она зависит от изменения
диффузионной составляющей тока, ее называют диффузионной. Диффузионная
емкость представляет собой отношение приращения инжекционного заряда dQинж
к вызвавшему его изменению напряжения dUпр,
т. е. .
Рисунок 1.13 Зависимость барьерной (а) и диффузионной (б) емкостей p-n перехода от напряжения.
Тогда диффузионная емкость, обусловленная изменением общего заряда неравновесных дырок в n-области, определится по формуле
Аналогично для диффузионной емкости, обусловленной инжекцией электронов в p-область,
Рисунок 1.13 Эквивалентная схема p-n перехода. Общая диффузионная емкость
Зависимость ёмкости от прямого напряжения на p-n переходе показана на рисунке 1.13, б. Полная емкость p-n перехода определяется суммой зарядной и диффузионной емкостей:
При включении p-n перехода в прямом направлении преобладает диффузионная емкость, а при включении в обратном направлении - зарядная. На рис. 1.14 приведена эквивалентная схема p-n перехода по переменному току. Схема содержит дифференциальное сопротивление p-n перехода rД, диффузионную емкость СДИФ, барьерную емкость СБАР и сопротивление объема p- и n-областей r1. На основании уравнения (1.37) можно записать:
Если при прямом включении p-n перехода Uпр >> jт, то:
При комнатной температуре (в соотношении (1.42) значение тока подставляется в амперах). Сопротивление утечки rУТ учитывает возможность прохождения тока по поверхности кристалла из-за несовершенства его структуры. При прямом включении p-n перехода СБАР << СДИФ, дифференциальное сопротивление rД ПР мало и соизмеримо с r1, поэтому эквивалентная схема принимает вид, показанный на рис. 1.15, а.
Рисунок 1.15 Упрощенные эквивалентные схемы p-n перехода. При обратном смещении rД ОБР >> r1, СБАР >> СДИФ и эквивалентная схема имеет вид, показанный на рис. 1.15, б. 1.4 РАЗНОВИДНОСТИ ЭЛЕКТРИЧЕСКИХ ПЕРЕХОДОВ 1.4.1 Гетеропереходы Гетеропереход образуется двумя полупроводниками, различающимися шириной запрещенной зоны. Параметры кристаллических решеток полупроводников, составляющих гетеропереход, должны быть близки, что ограничивает выбор материалов. В настоящее время наиболее исследованными являются пары: германий-арсенид галлия, арсенид галлия-мышьяковидный индий, германий-кремний. Различают n-p и p-n гетеропереходы (на первое место ставится буква, обозначающая тип электропроводности полупроводника с более узкой запрещенной зоной). На основе гетеропереходов возможно также создание структур n-n и p-p.
Рисунок 1.16 Упрощенная энергетическая диаграмма p-n гетероперехода в равновесном состоянии. На рисунке 1.16 приведена упрощенная энергетическая диаграмма n-p перехода между арсенидом галлия р-типа (DWP = 1,5 эВ) и германием n-типа (DWn = 0,67 эВ) в состоянии равновесия (U = 0). При контакте полупроводников происходит перераспределение носителей зарядов, приводящее к выравниванию уровней Ферми p- и n-областей и возникновению энергетического барьера для электронов n-области q×Ukn и. для дырок p-области q×Uкp, причем Uкn > Uкp.
Рисунок 1.17 Упрощенная энергетическая диаграмма p-n гетероперехода, включенного в прямом состоянии. В состоянии равновесия ток через n-p переход равен нулю. Поскольку потенциальные барьеры для дырок и электронов различны, при приложении к гетеропереходу прямого напряжения смещения он обеспечит эффективную инжекцию дырок из полупроводника с большей шириной запрещенной зоны (рис. 1.17). 1.4.2 Контакт между полупроводниками одного типа электропроводности Контакт полупроводников с одним типом электропроводности, но с разной концентрацией примесей обозначают р+-р или п+-п (знаком "плюс" отмечается полупроводник с большей концентрацией примесей). В таких контактах носители из области с большей концентрацией примеси переходят в область с меньшей концентрацией. При этом в области с повышенной концентрацией нарушается компенсация зарядов ионизированных атомов примеси, а в другой области создается избыток основных носителей зарядов. Образование этих зарядов приводит к появлению на переходе собственного электрического поля и контактной разности потенциалов, определяемой следующими соотношениями: для p+-р перехода
для n+-n
перехода В этих переходах не образуется слой с малой концентрацией носителей зарядов, и их сопротивление определяется в основном сопротивлением низкоомной области. Поэтому при прохождении тока непосредственно на контакте падает небольшое напряжение и выпрямительные свойства этих переходов не проявляются. В p+-p и n+-n- переходах отсутствует инжекция неосновных носителей из низкоомной области в высокоомную. Если, например, к переходу n+-n подключен источник тока плюсом к n-области, а минусом к n+-области, то из n+-области в n-область будут переходить электроны, являющиеся в ней основными носителями зарядов. При изменении полярности внешнего напряжения из n+-области в n-область должны инжектироваться дырки, однако их концентрация мала, и этого явления не происходит. Переходы типа p+-p и n+-n возникают при изготовлении омических контактов к полупроводникам.
Рисунок 1.18 Энергетическая диаграмма p-i перехода. Промежуточное положение между p+-p- или n+-n- и p-n переходом занимают p-i и n-i переходы. Такие переходы образуются между двумя пластинами, одна из которых имеет электронную или дырочную электропроводность, а другая - собственную. На рис 1.18
показаны энергетическая диаграмма и изменение концентраций на границе двух полупроводников
с p- и i-областями. Вследствие
разности концентраций носителей зарядов в p- и i-областях происходит инжекция дырок из p-области
в i-область и электронов из i-области
в p-область. Вследствие малой величины инжекционной
составляющей электронного тока потенциальный барьер на границе перехода создается
неподвижными отрицательными ионами акцепторов р-области и избыточными дырками i-области, диффундирующими в нее из p-области.
Поскольку 1.4.3 Контакт металла с полупроводником Свойства контакта металла с полупроводником зависят от работы выхода электронов из металла (W0м) и из полупроводника (W0n или W0p). Электроны переходят из материала с меньшей работой выхода в материал с большей работой выхода. При контакте металла с электронным полупроводником при выполнении условия W0n < W0p электроны переходят из полупроводника в металл. Если осуществлен контакт металла с дырочным полупроводником и выполняется условие W0м < W0p, будет происходить переход электронов в полупроводник. И в том, и в другом случае произойдет обеднение свободными носителями заряда приконтактной области полупроводника. Обедненный слой обладает повышенным сопротивлением, которое может изменяться под воздействием внешнего напряжения. Следовательно, такой контакт имеет нелинейную характеристику и является выпрямляющим. Перенос зарядов в этих контактах осуществляется основными носителями, и в них отсутствуют явления инжекции, накопления и рассасывания зарядов. Таким образом, выпрямляющие контакты металл-полупроводник малоинерционны и служат основой создания диодов с барьером Шоттки, обладающих высоким быстродействием и малым временем переключения. Если при контакте металла с полупроводником выполняется условие W0м < W0м или W0м > W0p, то приконтактный слой полупроводника обогащается основными носителями заряда и его сопротивление становится низким при любой полярности внешнего напряжения. Такой контакт имеет практически линейную характеристику и является невыпрямляющим. 1.4.4 Омические контакты Омическими называют контакты, сопротивление которых не зависит от величины и направления тока. Другими словами, это контакты, обладающие практически линейной вольт-амперной характеристикой. Омические контакты обеспечивают соединение полупроводника с металлическими токопроводящими элементами полупроводниковых приборов. Кроме линейности вольт-амперной характеристики, эти контакты должны иметь малое сопротивление и обеспечивать отсутствие инжекции носителей из металлов в полупроводник. Эти условия выполняются путем введения между полупроводником рабочей области кристалла и металлом полупроводника с повышенной концентрацией примеси (рис. 1.19). Контакт между полупроводниками с одинаковым типом электропроводности является невыпрямляющим и низкоомным. Металл выбирают так, чтобы обеспечить малую контактную разность потенциалов. Одним из способов получения омических контактов является введение в металл примеси, которой легирован полупроводник. В этом случае при сплавлении металла с полупроводником в контактной области образуется тонкий слой вырожденного полупроводника, что соответствует структуре, изображенной на рис. 1.19.
Рисунок 1.19 Структура омического контакта. 1.4.5 Явления на поверхности полупроводника В результате взаимодействия полупроводника и окружающей среды на поверхности кристалла образуются различные соединения, отличающиеся по своим свойствам от основного материала. Кроме того, обработка кристалла приводит к дефектам кристаллической решетки на поверхности полупроводника. По этим причинам возникают поверхностные состояния, повышающие вероятность появления свободных электронов или незаполненных ковалентных связей. Энергетические уровни поверхностных состояний могут располагаться в запрещенной энергетической зоне и соответствовать донорным и акцепторным примесям. Поверхностные состояния меняют концентрацию носителей заряда, и в приповерхностном слое полупроводника возникает объемный заряд, приводящий к изменению уровня Ферми. Поскольку в состоянии равновесия уровень Ферми во всем кристалле полупроводника одинаков, поверхностные состояния вызывают искривление энергетических уровней в приповерхностном слое полупроводника. В зависимости от типа полупроводника и характера поверхностных состояний может происходить обеднение или обогащение поверхности кристалла носителями заряда. Обеднение возникает в том случае, если поверхностный заряд совпадает по знаку с основными носителями заряда. На рис. 1.20 показано образование обедненного слоя на поверхности полупроводника n-типа при такой плотности поверхностных состояний, что уровни Win и Wфn не пересекаются. Повышение плотности пространственного заряда может привести к пересечению уровня Ферми с уровнем середины запрещенной зоны (рис. 1.21), что соответствует изменению типа электропроводности у поверхности полупроводника. Это явление называют инверсией типа электропроводности, а слой, в котором. оно наблюдается, - инверсным слоем.
Если знаки поверхностного заряда и основных носителей противоположны, происходит обогащение приповерхностной области основными носителями зарядов. Такую область называют обогащенным слоем (рис. 1.22). Электропроводность приповерхностного слоя полупроводника может изменяться под действием электрического поля, возникающего за счет напряжения, прикладываемого к металлу и полупроводнику, разделенным диэлектриком. Если предположить, что до включения напряжения поверхностные состояния на границе полупроводника и диэлектрика отсутствуют, то электропроводности приповерхностного слоя и объема полупроводника будут одинаковыми. При включении напряжения между металлом и полупроводником возникает электрическое поле, и на поверхности металла и в приповерхностном слое полупроводника, как на пластинах конденсатора, накапливаются заряды. Например, если полупроводник электронный и к нему прикладывается отрицательное напряжение, то под действием электрического поля у
поверхности увеличиваются концентрация электронов и электропроводность приповерхностного слоя полупроводника (см. рис. 1.22). При изменении полярности напряжения концентрация электронов в приповерхностном слое уменьшается, а дырок - увеличивается. В связи с этим электропроводность приконтактной области уменьшается, стремясь к собственной. Увеличение напряжения приводит к тому, что концентрация дырок становится выше концентрации электронов и происходит изменение (инверсия) типа электропроводности слоя. При этом электропроводность приповерхностного слоя увеличивается. Зависимость электропроводности приповерхностного слоя полупроводника n-типа от напряжения показана на рис. 1.23. Это явление принято называть эффектом поля. 2 ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ 2.1 Классификация Классификация полупроводниковых диодов производится по следующим признакам: - методу изготовления перехода: сплавные, диффузионные, планарные, точечные, диоды Шоттки и др.; - материалу: германиевые, кремниевые, арсенидо-галлиевые и др.; - физическим процессам, на использовании которых основана работа диода: туннельные, лавинно-пролетные, фотодиоды, светодиоды. диоды Ганна и др.; - назначению: выпрямительные, универсальные, импульсные, стабилитроны, детекторные, параметрические, смесительные, СВЧ-диоды и др. Некоторые из указанных типов диодов по назначению будут рассмотрены в настоящей главе, а другие - в соответствующих разделах учебного пособия. 2.2 Выпрямительные диоды Выпрямительными обычно называют диоды, предназначенные для преобразования переменного напряжения промышленной частоты (50 или 400 Гц) в постоянное. Основой диода является обычный p-n переход. В практических случаях p-n переход диода имеет достаточную площадь для того, чтобы обеспечить большой прямой ток. Для получения больших обратных (пробивных) напряжений диод обычно выполняется из высокоомного материала. |
Приглашения09.12.2013 - 16.12.2013 Международный конкурс хореографического искусства в рамках Международного фестиваля искусств «РОЖДЕСТВЕНСКАЯ АНДОРРА»09.12.2013 - 16.12.2013 Международный конкурс хорового искусства в АНДОРРЕ «РОЖДЕСТВЕНСКАЯ АНДОРРА»
|
Copyright © 2012 г.
При использовании материалов - ссылка на сайт обязательна.

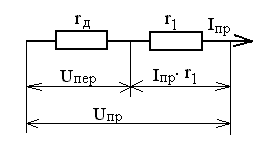
 .
. ,
,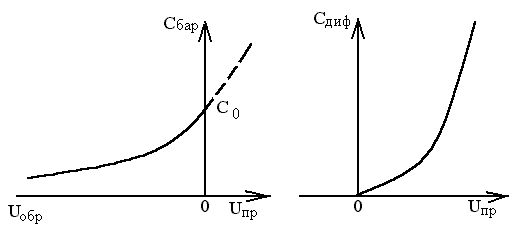
 .
. .
. .
.