 |
|
МЕНЮФестивали и конкурсы Семинары Издания О МОДНТ Приглашения Поздравляем НАУЧНЫЕ РАБОТЫ |
Реферат: Физические основы электроникиИз соотношения (1.6) видно, что в полупроводниках n-типа уровень Ферми располагается в верхней половине запрещенной зоны, и тем ближе к зоне проводимости, чем больше концентрация доноров. При увеличении температуры уровень Ферми смещается к середине запрещенной зоны за счет ионизации основных атомов полупроводника. Повышение концентрации электронов в данном полупроводнике значительно снижает его удельное сопротивление. Например, чистый кремний имеет r = 2×103 Ом× м, а легированный фосфором - (0,25...0,4)×102 Ом×м. 1.1.3 Полупроводники с дырочной электропроводностью Если в кристалле 4-валентного элемента часть атомов замещена атомами 3-валентного элемента (галлия Ga, индия In), то для образования четырех ковалентных связей у примесного атома не хватает одного электрона (рис. 1.5, а). Этот электрон может быть получен от атома основного элемента полупроводника за счет разрыва ковалентной связи. Разрыв связи приводит к появлению дырки, так как сопровождается образованием свободного уровня в валентной зоне. Примеси, захватывающие электроны из валентной зоны, называют акцепторными или акцепторами. Энергия активизации акцепторов составляет для германия 0,0102-0,0112 эВ и для кремния 0,045-0,072 эВ, что значительно меньше ширины запрещенной зоны беспримесного полупроводника. Следовательно, энергетические уровни примесных атомов располагаются вблизи валентной зоны (рис. 1.5, б). Ввиду малого значения энергии активизации акцепторов уже при комнатной температуре электроны из валентной зоны переходят на уровни акцепторов. Эти электроны, превращая примесные атомы в отрицательные ионы, теряют способность перемещаться по кристаллической решетке, а образовавшиеся при этом дырки могут участвовать в создании электрического тока. За счет ионизации атомов исходного материала из валентной зоны часть электронов попадает в зону проводимости. Однако электронов в зоне проводимости значительно меньше, чем дырок в валентной зоне. Поэтому дырки в таких полупроводниках являются основными, а электроны - неосновными
Рисунок 1.5 Условное изображение кристаллической решетки (а) и энергетическая диаграмма (б) полупроводника с дырочной электропроводностью. подвижными носителями заряда.
Такие полупроводники носят название полупроводников с дырочной
электропроводностью или полупроводников р-типа. В состоянии теплового
равновесия концентрация дырок в полупроводнике р-типа (
Из уравнений
(1.7) и (1.8) следует, что для полупроводника р-типа выполняется неравенство Если считать,
что при комнатной температуре все акцепторные атомы ионизированы, т. е. где Na — концентрация акцепторных атомов в полупроводнике. Соотношение (1.9) показывает, что уровень Ферми в полупроводнике р-типа располагается в нижней половине запрещенной зоны, так как Na >> ni, и при повышении температуры смещается к середине запрещенной зоны за счет ионизации атомов основного полупроводника. Кроме того, на основании уравнений (1.4), (1.5), (1.7) и (1.8) можно записать следующее выражение:
которое показывает, что введение в полупроводник примесей приводит к увеличению концентрации одних носителей заряда и пропорциональному уменьшению концентрации других носителей заряда за счет роста вероятности их рекомбинации. 1.2 ТОКИ В ПОЛУПРОВОДНИКАХ 1.2.1 Дрейфовый ток В полупроводниках свободные электроны и дырки находятся в состоянии хаотического движения. Поэтому, если выбрать произвольное сечение внутри объема полупроводника и подсчитать число носителей заряда, проходящих через это сечение за единицу времени слева направо и справа налево, значения этих чисел окажутся одинаковыми. Это означает, что электрический ток в данном объеме полупроводника отсутствует. При помещении полупроводника в электрическое поле напряженностью Е на хаотическое движение носителей зарядов накладывается составляющая направленного движения. Направленное движение носителей зарядов в электрическом поле обусловливает появление тока, называемого дрейфовым (Рисунок 1.6, а ) Из-за столкновения носителей зарядов с атомами кристал- лической решетки их движение в направлении действия электрического поля
прерывисто и характеризуется
подвижностью m. Подвижность равна средней
скорости
Подвижность носителей зарядов зависит от механизма их рассеивания в кристаллической решетке. Исследования показывают, что подвижности электронов mn и дырок mp имеют различное значение (mn > mp) и определяются температурой и концентрацией примесей. Увеличение температуры приводит к уменьшению подвижности, что зависит от числа столкновений носителей зарядов в единицу времени. Плотность тока
в полупроводнике, обусловленного дрейфом свободных электронов под действием
внешнего электрического поля со средней скоростью Перемещение
(дрейф) дырок в валентной зоне со средней скоростью Подставляя в выражение для плотности тока соотношение для средней скорости электронов и дырок (1.11), получаем
Если сравнить выражение (1.12) с законом Ома j =sЕ, то удельная электропроводность полупроводника определяется соотношением
У полупроводника с собственной электропроводностью концентрация электронов равна концентрации дырок (ni = pi), и его удельная электропроводность определяется выражением
В
полупроводнике n-типа
В
полупроводнике р-типа
В области высоких температур концентрация электронов и дырок значительно возрастает за счет разрыва ковалентных связей и, несмотря на уменьшение их подвижности, электропроводность полупроводника увеличивается по экспоненциальному закону. 1.2.2 Диффузионный ток Кроме теплового возбуждения, приводящего к возникновению равновесной концентрации зарядов, равномерно распределенных по объему полупроводника, обогащение полупроводника электронами до концентрации np и дырками до концентрации pn может осуществляться его освещением, облучением потоком заряжённых частиц, введением их через контакт (инжекцией) и т. д. В этом случае энергия возбудителя передается непосредственно носителям заряда и тепловая энергия кристаллической решетки остается практически постоянной. Следовательно, избыточные носители заряда не находятся в тепловом равновесии с решеткой и поэтому называются неравновесными. В отличие от равновесных они могут неравномерно распределяться по объему полупроводника (рисунок 1.6, б) После прекращения действия возбудителя за счет рекомбинации электронов и дырок концентрация избыточных носителей быстро убывает и достигает равновесного значения. Скорость
рекомбинации неравновесных носителей пропорциональна избыточной концентрации
дырок (pn -
где tp - время жизни дырок; tn - время жизни электронов. За время жизни концентрация неравновесных носителей уменьшается в 2,7 раза. Время жизни избыточных носителей составляет 0,01...0,001 с. Носители зарядов рекомбинируют в объеме полупроводника и на его поверхности. Неравномерное распределение неравновесных носителей зарядов сопровождается их диффузией в сторону меньшей концентрации. Это движение носителей зарядов обусловливает прохождение электрического тока, называемого диффузионным (рисунок 1.6, б). Рассмотрим одномерный случай. Пусть в полупроводнике концентрации электронов n(x) и дырок p(x) являются функциями координаты. Это приведет к диффузионному движению дырок и электронов из области с большей их концентрацией в область с меньшей концентрацией. Диффузионное движение носителей зарядов обусловливает прохождение диффузионного тока электронов и дырок, плотности которых определяются из соотношений:
где dn(x)/dx, dp(x)/dx - градиенты концентраций электронов и дырок; Dn, Dp - коэффициенты диффузии электронов и дырок. Градиент концентрации характеризует степень неравномерности распределения зарядов (электронов и дырок) в полупроводнике вдоль какого-то выбранного направления (в данном случае вдоль оси x). Коэффициенты диффузии показывают количество носителей заряда, пересекающих в единицу времени единичную площадку, перпендикулярную к выбранному направлению, при градиенте концентрации в этом направлении, равном единице. Коэффициенты диффузии связаны с подвижностями носителей зарядов соотношениями Эйнштейна:
Знак "минус" в выражении (1.14) означает противоположную направленность электрических токов в полупроводнике при диффузионном движении электронов и дырок в сторону уменьшения их концентраций. Если в полупроводнике существует и электрическое поле, и градиент концентрации носителей, проходящий ток будет иметь дрейфовую и диффузионную составляющие. В таком случае плотности токов рассчитываются по следующим уравнениям:
1.3 КОНТАКТНЫЕ ЯВЛЕНИЯ 1.3.1 Электронно-дырочный переход в состоянии равновесия Принцип действия большинства полупроводниковых приборов основан на физических явлениях, происходящих в области контакта твердых тел. При этом преимущественно используются контакты: полупроводник-полупроводник; металл-полупроводник; металл-диэлектрик-полупроводник. Если переход создается между полупроводниками n-типа и p-типа, то его называют электронно-дырочным или p-n переходом. Электронно-дырочный переход создается в одном кристалле полупроводника с использованием сложных и разнообразных технологических операций. Рассмотрим p-n переход, в котором концентрации
доноров Nд и акцепторов Na
изменяются скачком на границе раздела (рис. 1.7, а). Такой p-n переход называют резким. Равновесная концентрация дырок в p-области (
Электроны и дырки, переходя через контакт навстречу друг другу (благо- даря диффузии), рекомбинируют и в приконтактной области дырочного полу- проводника образуется нескомпенсированный заряд отрицательных ионов акцепторных примесей, а в электронном полупроводнике нескомпенсирован -ный заряд положительных донорных ионов (рис. 1.6, в). Таким образом, электронный полупроводник заряжается положительно, а дырочный - отрицательно. Между областями с различными типами электропроводности возникает собственное электрическое поле напряженностью Eсоб (рис. 1.7, а), созданное двумя слоями объемных зарядов. Этому полю соответствует разность потенциалов Uк между n- и p-областями, называемая контактной (рис. 1.7, г). За пределами области объемного заряда полупроводниковые области n- и р-типа остаются электрически нейтральными. Собственное
электрическое поле является тормозящим для основных носителей заряда и
ускоряющим для неосновных. Электроны p-области и Рисунок 1.7 Равновесное состояние p-n перехода. дырки n-области, совершая тепловое движение, попадают в пределы диффузионного электрического поля, увлекаются им и перебрасываются в противоположные области, образуя ток дрейфа, или ток проводимости. Выведение носителей заряда из области полупроводника, где они являются неосновными, через электронно-дырочный переход ускоряющим электрическим полем называют экстракцией носителей заряда. Используя выражение (1.12) и учитывая, что Е = -dU/dx, определяем плотность полного дрейфового тока через границу раздела p- и n-областей:
Так как через изолированный полупроводник ток проходить не должен, между диффузионным и дрейфовым токами устанавливается динамическое равновесие:
Приконтактную область, где имеется собственное электрическое поле, называют p-n переходом. Поскольку потенциальная энергия электрона и потенциал связаны соотношением W = -qU, образование нескомпенсированных объемных зарядов вызывает понижение энергетических уровней n-области и повышение энергетических уровней р-области. Смещение энергетических диаграмм прекратится, когда уровни Ферми W фn и W фp совпадут (рис. 1.7, д). При этом на границе раздела (x = 0) уровень Ферми проходит через середину запрещенной зоны. Это означает, что в плоскости сечения x = 0 полупроводник характеризуется собственной электропроводностью и обладает по сравнению с остальным объемом повышенным сопротивлением. В связи с этим его называют запирающим слоем или областью объемного заряда. Совпадение уровней Ферми n- и p-областей соответствует установлению динамического равновесия между областями и возникновению между ними потенциального барьера Uk для диффузионного перемещения через p-n переход электронов n-области и дырок p-области. Из рис. 1.7, д следует, что потенциальный барьер
Подстановка в это выражение результатов логарифмирования соотношений (1.4), (1.7) позволяет получить следующее равенство:
Если обозначить jт = kT/q и учесть уравнение (1.10), то можно записать:
Из уравнений (1.16) и (1.17) следует:
При комнатной температуре (Т = 300 К) jт » 0,026 В. Таким образом, контактная разность потенциалов зависит от отношения концентраций носителей зарядов одного знака в р- и n-областях полупроводника. Другим важным параметром p-n перехода является его ширина, обозначаемая d = dp + dn. Ширину запирающего слоя d можно найти, решив уравнения Пуассона для n-области и p-области:
Решения уравнений (1.19) и (1.20) при граничных условиях
имеют вид:
В точке x = 0 оба решения должны давать одинаковые значения j и |
Приглашения09.12.2013 - 16.12.2013 Международный конкурс хореографического искусства в рамках Международного фестиваля искусств «РОЖДЕСТВЕНСКАЯ АНДОРРА»09.12.2013 - 16.12.2013 Международный конкурс хорового искусства в АНДОРРЕ «РОЖДЕСТВЕНСКАЯ АНДОРРА»
|
||||
Copyright © 2012 г.
При использовании материалов - ссылка на сайт обязательна.


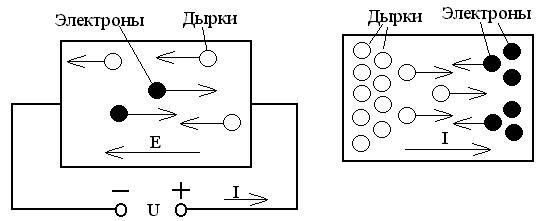
 ; (1.13)
; (1.13)  ; (1.14)
; (1.14) .
.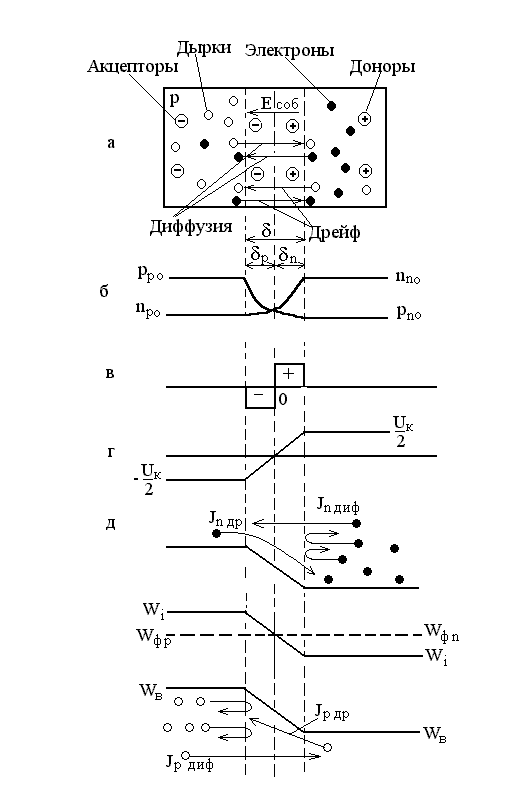
 ; (1.16)
; (1.16)  .
(1.17)
.
(1.17)


 для
-dp
< x < 0;
для
-dp
< x < 0;  для 0 < x <dn; (1.21)
для 0 < x <dn; (1.21) и
и 
